CoWoSдҫӣзөҰйҖјиҝ«гҖҒе°Ғжё¬еҗ„зӨҫгҒҜFOPLPгҒёгӮ·гғ•гғҲ
еҠӣжҲҗгҒҜ27е№ҙйҮҸз”ЈзӢҷгҒ„гҖҒж—ҘжңҲе…үгғ»зҹҪе“ҒгӮӮеёғзҹі
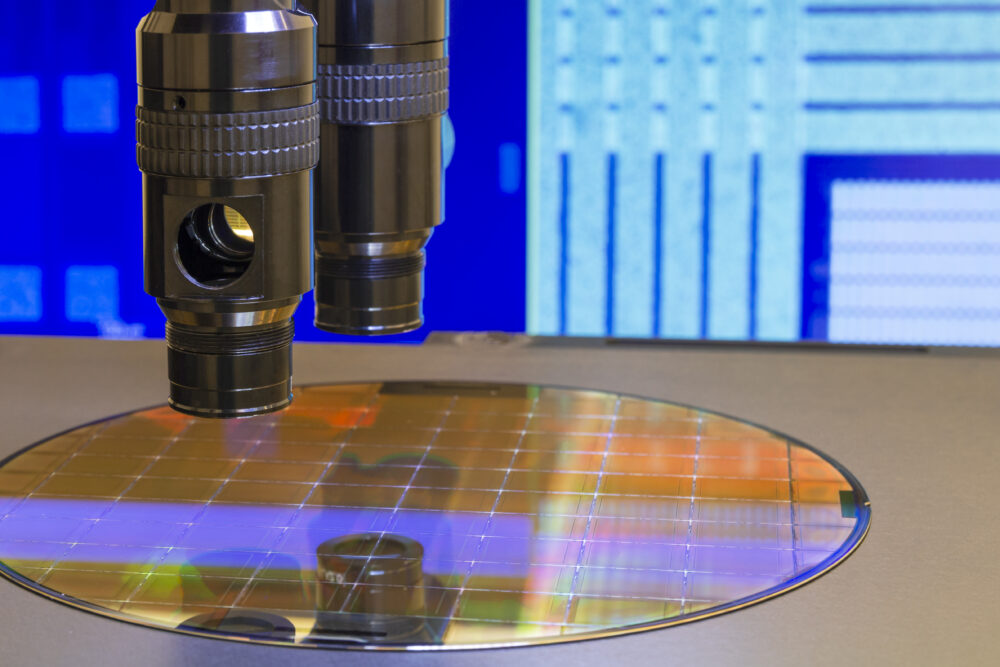
AIпјҲдәәе·ҘзҹҘиғҪпјүгҒҠгӮҲгҒій«ҳжҖ§иғҪиЁҲз®—пјҲHPCпјүеҗ‘гҒ‘еҚҠе°ҺдҪ“гҒ®йңҖиҰҒгҒҢеҠӣеј·гҒҸжӢЎеӨ§гҒҷгӮӢдёӯгҖҒеҚҠе°ҺдҪ“еҸ—иЁ—з”ҹз”ЈпјҲгғ•гӮЎгӮҰгғігғүгғӘгғјпјүдё–з•ҢеӨ§жүӢгҒ®еҸ°ж№ҫз©ҚдҪ“йӣ»и·ҜиЈҪйҖ пјҲTSMCгҖҒеҸ°з©Қйӣ»пјүгҒ®е…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёжҠҖиЎ“гҖҢCoWoSгҖҚгҒҜд»Ҡе№ҙгӮӮдҫӣзөҰйҖјиҝ«гҒҢз¶ҡгҒ„гҒҰгҒ„гӮӢгҖӮгҒ“гӮҢгӮ’еҸ—гҒ‘гҖҒеҸ°ж№ҫгҒ®еҠӣжҲҗпјҲPTIпјүгҖҒж—ҘжңҲе…үпјҲASEпјүгҖҒзҹҪе“ҒпјҲSPILпјүгҒӘгҒ©еҸ°ж№ҫгҒ®е°Ғжё¬еӨ§жүӢгҒҜгҖҒжүҮеҮәеһӢе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёжҠҖиЎ“гҒ®жӢЎе……гӮ’жҖҘгҒҺгҖҒж–°гҒҹгҒӘеҸ—жіЁзҚІеҫ—гҒ«еӢ•гҒ„гҒҰгҒ„гӮӢгҖӮгӮігӮ№гғҲйқўгӮ„еӨ§йқўз©ҚеҜҫеҝңгҒ«е„ӘдҪҚжҖ§гӮ’жҢҒгҒӨжүҮеҮәеһӢгғ‘гғғгӮұгғјгӮёгҒҜгҖҒж—©гҒ‘гӮҢгҒ°2027е№ҙеҲқй ӯгҒ«гӮӮйҮҸз”Јгғ“гӮёгғҚгӮ№гҒҢз«ӢгҒЎдёҠгҒҢгӮӢгҒЁиҰӢиҫјгҒҫгӮҢгҒҰгҒ„гӮӢгҖӮ
TSMCгҒҜ1жңҲдёӯж—¬гҒ®жі•иӘ¬жҳҺдјҡгҒ§гҖҒд»Ҡе№ҙгӮӮе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёеҲҶйҮҺгҒёгҒ®жҠ•иіҮгӮ’жӢЎеӨ§гҒҷгӮӢж–№йҮқгӮ’зӨәгҒ—гҖҒеҗҢеҲҶйҮҺгҒ®еЈІдёҠй«ҳгҒҢе…ЁдҪ“гҒ®10пј…гӮ’и¶…гҒҲгӮӢеҸҜиғҪжҖ§гҒҢгҒӮгӮӢгҒЁиӘ¬жҳҺгҒ—гҒҹгҖӮдёҖж–№гҖҒCoWoSгҒ®дҫӣзөҰгҒҢйҷҗгӮүгӮҢгӮӢдёӯгҖҒд»–гҒ®еҚҠе°ҺдҪ“гғЎгғјгӮ«гғјгӮ„е°Ғжё¬еҗ„зӨҫгҒҜе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёиғҪеҠӣгҒ®еў—еј·гҒ«жіЁеҠӣгҒ—гҒҰгҒҠгӮҠгҖҒзү№гҒ«жүҮеҮәеһӢгғ‘гғғгӮұгғјгӮёгҒҢйҮҚзӮ№еҲҶйҮҺгҒЁгҒӘгҒЈгҒҰгҒ„гӮӢгҖӮ
жҘӯз•Ңй–ўдҝӮиҖ…гҒ«гӮҲгӮӢгҒЁгҖҒTSMCгҖҒж—ҘжңҲе…үгҖҒеҠӣжҲҗгҖҒзҫӨеүөгҖҒзҹҪе“ҒгҒӘгҒ©еҸ°ж№ҫеӢўгҒҜгҖҒжүҮеҮәеһӢгғ‘гғҚгғ«гғ¬гғҷгғ«гғ‘гғғгӮұгғјгӮёпјҲFOPLPпјүгҒ®еёғеұҖгӮ’еҠ йҖҹгҒ—гҒҰгҒ„гӮӢгҖӮгҒ•гӮүгҒ«гҖҒгӮўгғ гӮігғјпјҲAmkorпјүгҖҒNepesгҖҒгӮөгғ гӮ№гғійӣ»еӯҗеӮҳдёӢгҒ®гӮөгғ гӮ№гғійӣ»ж©ҹпјҲSEMCOпјүгҒӘгҒ©жө·еӨ–еӢўгӮӮеҗҢжҠҖиЎ“гҒ«еҸӮе…ҘгҒ—гҒҰгҒ„гӮӢгҖӮдёӯгҒ§гӮӮгӮўгғ гӮігғјгҒҜгҖҒгӮ·гғӘгӮігғігӮҰгӮЁгғҸгғјзөұеҗҲеһӢгҒ®жүҮеҮәгғ‘гғғгӮұгғјгӮёжҠҖиЎ“гҖҢS-SwiftгҖҚгӮ’йҖҡгҒҳгҖҒAIгғҒгғғгғ—еӨ§жүӢгӮЁгғҢгғ“гғҮгӮЈгӮўпјҲNVIDIAпјүеҗ‘гҒ‘еҸ—жіЁгҒ®жӢЎеӨ§гӮ’зӢҷгҒЈгҒҰгҒ„гӮӢгҖӮ
е°Ғжё¬еӨ§жүӢгҒ®еҠӣжҲҗгҒҜFOPLPгҒёгҒ®жҠ•иіҮгӮ’з©ҚжҘөеҢ–гҒ—гҒҰгҒҠгӮҠгҖҒи”ЎзҜӨжҒӯи‘ЈдәӢй•·гҒҜгҖҒеҗҢзӨҫгҒҢFOPLPгӮ’дёӯж ёгҒЁгҒҷгӮӢAIгғҒгғғгғ—еҗ‘гҒ‘гҒ®еҢ…жӢ¬зҡ„гҒӘе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёгӮҪгғӘгғҘгғјгӮ·гғ§гғігӮ’жҸҗдҫӣгҒ§гҒҚгӮӢгҒЁиӘ¬жҳҺгҒ—гҒҹгҖӮеҜҫиұЎгҒҜAIгғҒгғғгғ—гҖҒCPUгҖҒASICгҒ«еҠ гҒҲгҖҒе…үеӯҰгӮЁгғігӮёгғігӮ„гӮ·гғӘгӮігғігғ•гӮ©гғҲгғӢгӮҜгӮ№гҒЁзөұеҗҲгҒ—гҒҹAIгғҒгғғгғ—пјҲCPOпјүгҒӘгҒ©гҒ«гӮӮеәғгҒҢгҒЈгҒҰгҒ„гӮӢгҖӮ
и”Ўж°ҸгҒҜгҖҒд»Ҡе№ҙжң«гҒҫгҒ§гҒ«FOPLPгҒ®йЎ§е®ўиӘҚиЁјгӮ’е®ҢдәҶгҒ—гҖҒжңҖзҹӯгҒ§2027е№ҙеҲқй ӯгҒ«йҮҸз”ЈгӮ’й–Ӣе§ӢгҖҒ2028е№ҙеҚҠгҒ°гҒ«гҒҜз”ҹз”ЈиғҪеҠӣгҒҢгғ•гғ«зЁјеғҚгҒ«гҒӘгӮӢгҒЁгҒ®иҰӢйҖҡгҒ—гӮ’зӨәгҒ—гҒҹгҖӮгҒҫгҒҹгҖҒTSMCгҒҢеұ•й–ӢгҒҷгӮӢCoWoS-LгҒҠгӮҲгҒіCoWoS-RгҒЁгҖҒеҠӣжҲҗгҒҢй•·е№ҙеҸ–гӮҠзө„гӮ“гҒ§гҒҚгҒҹFOPLPгҒҜжҠҖиЎ“зҡ„гҒ«иҝ‘гҒҸгҖҒFOPLPгҒҜгӮҲгӮҠеӨ§йқўз©ҚеҜҫеҝңгҒҢеҸҜиғҪгҒӘзӮ№гҒ§еӨ§гҒҚгҒӘж©ҹдјҡгҒ«гҒӘгӮӢгҒЁиҝ°гҒ№гҒҹгҖӮ
еҠӣжҲҗгҒ«гӮҲгӮҢгҒ°гҖҒеҗҢзӨҫгҒ®FOPLPжҠҖиЎ“гҒҜеӨ§гҒҚгҒҸ4зЁ®йЎһгҒ«еҲҶйЎһгҒ•гӮҢгҖҒchip-lastж–№ејҸгҒҜгӮ¬гғ©гӮ№еҹәжқҝгӮ’з”ЁгҒ„гҒҹеҶҚй…Қз·ҡпјҲRDLпјүгӮ’зө„гҒҝеҗҲгӮҸгҒӣгҖҒTSMCгҒ®CoWoS-RгҒ«йЎһдјјгҒҷгӮӢгҖӮдёҖж–№гҖҒchip-middleж–№ејҸгҒҜCoWoS-LгҒ«иҝ‘гҒ„ж§ӢжҲҗгҒЁгҒӘгҒЈгҒҰгҒҠгӮҠгҖҒAIгғҒгғғгғ—зөұеҗҲгғ—гғ©гғғгғҲгғ•гӮ©гғјгғ гҒ§гҒ®е°ҶжқҘжҖ§гӮ’иҰӢиҫјгӮ“гҒ§гҒ„гӮӢгҖӮ
жҘӯз•ҢгҒ§гҒҜгҖҒCoWoSгҒ®дё»иҰҒз”ҹз”ЈиғҪеҠӣгҒҢгӮЁгғҢгғ“гғҮгӮЈгӮўеҗ‘гҒ‘гҒ«е„Әе…Ҳзҡ„гҒ«еүІгӮҠеҪ“гҒҰгӮүгӮҢгҒҰгҒ„гӮӢгҒ“гҒЁгҒӢгӮүгҖҒд»–гҒ®AIгғҒгғғгғ—йЎ§е®ўгҒ®е…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёйңҖиҰҒгҒҢгҖҒеҠӣжҲҗгҒ®FOPLPгҒ«гҒЁгҒЈгҒҰйҮҚиҰҒгҒӘе•Ҷж©ҹгҒ«гҒӘгӮӢгҒЁгҒ®иҰӢж–№гҒҢеҮәгҒҰгҒ„гӮӢгҖӮ
ж—ҘжңҲе…үгҒҜгҖҢVIPackгҖҚе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёгғ—гғ©гғғгғҲгғ•гӮ©гғјгғ гҒ®ж§ӢзҜүгӮ’йҖІгӮҒгҖҒFOPoPгҖҒFOCoSгҖҒFOCoS-BridgeгҖҒFOSiPгҖҒTSVгӮ’з”ЁгҒ„гҒҹ2.5D/3D ICгҖҒгҒ•гӮүгҒ«е…үеӯҰзҙ еӯҗгҒ®е…ұеҗҢгғ‘гғғгӮұгғјгӮёгғігӮ°гҒӘгҒ©гҖҒ6гҒӨгҒ®дёӯж ёжҠҖиЎ“гӮ’зөұеҗҲгҖӮHPCгҖҒAIгҖҒж©ҹжў°еӯҰзҝ’еҗ‘гҒ‘гҒ«гҖҒй«ҳеёҜеҹҹе№…гғЎгғўгғӘгғјпјҲHBMпјүгӮ„е…үеӯҰйғЁе“ҒгӮ’зө„гҒҝиҫјгӮҖе…Ҳз«Ҝз”ЁйҖ”гӮ’зӢҷгҒЈгҒҰгҒ„гӮӢгҖӮ
FOCoS-BridgeгҒ«гҒӨгҒ„гҒҰж—ҘжңҲе…үгҒҜгҖҒAIгӮ„HPCгҒ§гҒҜйӣ»еҠӣдҫӣзөҰгҒҢиӨҮйӣ‘еҢ–гҒ—гҒҰгҒҠгӮҠгҖҒTSVгӮ’еӮҷгҒҲгҒҹе…Ҳз«Ҝгғ–гғӘгғғгӮёгғҒгғғгғ—гҒҢдёҚеҸҜж¬ гҒ гҒЁиӘ¬жҳҺгҒҷгӮӢгҖӮеҗҢзӨҫгҒ®й«ҳеҜҶеәҰгғ‘гғғгӮұгғјгӮёжҠҖиЎ“гҒҜгҖҒеҸ—еӢ•гғ»иғҪеӢ•гғҒгғғгғ—гӮ’еҶ…и”өгҒ—гҖҒйӣ»жәҗе®Ңе…ЁжҖ§гҒ®еҗ‘дёҠгҒЁзӣҙжҺҘгӮўгӮҜгӮ»гӮ№гҒ«гӮҲгӮӢжҖ§иғҪж”№е–„гӮ’еҸҜиғҪгҒ«гҒҷгӮӢгҒЁгҒ—гҒҰгҒ„гӮӢгҖӮ
жҘӯз•Ңй–ўдҝӮиҖ…гҒҜгҖҒж—ҘжңҲе…үгӮ„еҠӣжҲҗгҒҢйҖІгӮҒгӮӢжүҮеҮәеһӢгғ‘гғғгӮұгғјгӮёгҒҜгҖҒRDLе·ҘзЁӢгӮ’з”ЁгҒ„гӮӢгҒ“гҒЁгҒ§гӮігӮ№гғҲдҪҺжёӣгҒҢеҸҜиғҪгҒ§гҖҒгӮҰгӮЁгғҸгғјгӮөгӮӨгӮәгҒ®еҲ¶зҙ„гӮ’еҸ—гҒ‘гҒҡеӨ§йқўз©ҚеҢ–гҒ§гҒҚгӮӢзӮ№гӮ’еј·иӘҝгҒҷгӮӢгҖӮгҒ“гӮҢгҒ«гӮҲгӮҠгҖҒгӮҲгӮҠеӨҡгҒҸгҒ®HBMгӮ„з•°зЁ®гғҒгғғгғ—гӮ’зөұеҗҲгҒ§гҒҚгҖҒе°ҶжқҘгҒ®AIгӮөгғјгғҗгғјеҗ‘гҒ‘гғҒгғғгғ—гғ—гғ©гғғгғҲгғ•гӮ©гғјгғ гҒ®й«ҳеәҰеҢ–гғ»зөұеҗҲгғҲгғ¬гғігғүгҒ«йҒ©еҗҲгҒҷгӮӢгҒЁгҒҝгҒҰгҒ„гӮӢгҖӮ
ж—ҘжңҲе…үжҠ•иіҮжҺ§иӮЎеӮҳдёӢгҒ®зҹҪе“ҒгҒҜгҖҒжүҮеҮәеһӢгғһгғ«гғҒгғҒгғғгғ—гғўгӮёгғҘгғјгғ«пјҲFO-MCMпјүгӮ„гҖҒжүҮеҮәеһӢеҹӢгӮҒиҫјгҒҝгғ–гғӘгғғгӮёпјҲFO-EBпјүжҠҖиЎ“гӮ’й•·е№ҙгҒ«гӮҸгҒҹгӮҠй–ӢзҷәгҒ—гҒҰгҒҚгҒҹгҖӮеёӮе ҙй–ўдҝӮиҖ…гҒ«гӮҲгӮҢгҒ°гҖҒзҹҪе“ҒгҒҜHPCгӮ„AIгғҒгғғгғ—гҒ®еҫҢе·ҘзЁӢгҒ§гӮЁгғҢгғ“гғҮгӮЈгӮўгҒЁз·ҠеҜҶгҒӘеҚ”еҠӣй–ўдҝӮгҒ«гҒӮгӮҠгҖҒеҗҢзӨҫгҒ®гғҗгғігғ—е·ҘзЁӢгҒ§гӮӮгӮЁгғҢгғ“гғҮгӮЈгӮўгҒ®AIжӨңжҹ»гӮ·гӮ№гғҶгғ гӮ’жҺЎз”ЁгҒ—гҒҰгҒ„гӮӢгҒ“гҒЁгҒӢгӮүгҖҒе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёеҲҶйҮҺгҒ§гҒ®еҚ”жҘӯжӢЎеӨ§гҒҢжңҹеҫ…гҒ•гӮҢгҒҰгҒ„гӮӢгҖӮ
й–ўйҖЈиЁҳдәӢ
- гӮөгғ гӮ№гғігҖҒгҖҢ3.3DгҖҚе…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёгғігӮ°гӮ’26е№ҙ第2еӣӣеҚҠжңҹгҒ«йҮҸз”ЈеҢ–гҒӢпјқйҹ“еӣҪгғЎгғҮгӮЈгӮў
- гғ–гғ«гғјгғ»гӮӘгғјгӮ·гғЈгғігғ»гӮ№гғһгғјгғҲгғ»гӮ·гӮ№гғҶгғ гҒҢгғҷгғӘгӮ·гғӘгӮігғіиЈҪй«ҳжҖ§иғҪгғ—гғӯгӮ»гғғгӮөгғјгӮ’жҗӯијүгҒ—гҒҹгғҒгғғгғ—гғ¬гғғгғҲгғҷгғјгӮ№гҒ®иЈҪе“ҒгӮ’зҷәиЎЁ
- ж—ҘжңҲе…үгҖҒж—Ҙжң¬гҒӘгҒ©жө·еӨ–гҒ§е…Ҳз«Ҝгғ‘гғғгӮұгғјгӮёгғігӮ°е·Ҙе ҙж–°иЁӯжӨңиЁҺ
- йҪҠеҠӣеҚҠе°ҺдҪ“гҖҒжөҷжұҹзңҒгҒ«30е„„е…ғжҠ•гҒҳгғҒгғғгғ—гғ¬гғғгғҲе°Ғжӯўе·Ҙе ҙ
- зӣӣзҫҺдёҠжө·гҖҒFOPLPеҗ‘гҒ‘гғ‘гғҚгғ«гӮҒгҒЈгҒҚиЈ…зҪ®гӮ’зҷәиЎЁ
(500Г—80px)(450Г—80px)(460Г—80px)(470Г—80px)(2).png)




